Cetus, Capella
SPTのPECVD (プラズマ励起化学気相成長) システムは、シリコン酸化膜および窒化膜の高品質成膜を実現します。低ストレスかつ優れた膜厚均一性、ステップカバレッジにより、MEMSから光学コーティング、パッシベーション膜まで幅広い厚さレンジに対応可能です。
アプリケーション:
- MEMSデバイス
- インクジェットヘッド
- TSV
- パワーデバイス
- LED
- 光学デバイス
- RFデバイス (高周波デバイス)

PECVD
SPTのPECVD装置は、最先端のMEMSや半導体用途において、厚膜酸化膜および低応力SiNの安定した成膜を実現するよう設計されています。

SPTのPECVD (プラズマ励起化学気相成長) システムは、シリコン酸化膜および窒化膜の高品質成膜を実現します。低ストレスかつ優れた膜厚均一性、ステップカバレッジにより、MEMSから光学コーティング、パッシベーション膜まで幅広い厚さレンジに対応可能です。
特長
MEMSや光導波路用途向けに、厚膜SiO₂を高速かつボイド・クラックなく成膜できます。
高アスペクト比・狭幅TSV構造に対しても、低温で高い被覆性を持つ酸化膜の成膜が可能です。
化合物半導体のパッシベーションに適した、緻密かつ低水素SiN膜を提供します。
超低ストレスかつ高い均一性を持つSiN膜は、MEMS膜応用にも最適です。
真空ロードロック型・クラスター型構成に対応し、幅広い製造ニーズにお応えします。
性能
SPTのPECVD装置は、MEMSやTSV構造のような高要求プロセスにおいても、厚膜酸化膜・低ストレスSiN・高密着な成膜性能を安定して提供します。
信頼性とプロセス制御に優れた結果を獲得できます。
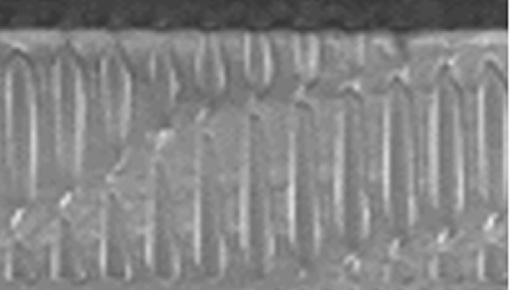
TSV構造におけるボイドレス酸化膜充填

厚膜シリコン酸化膜の成膜

低ストレスSiN成膜
(提供:ケンブリッジ大学)
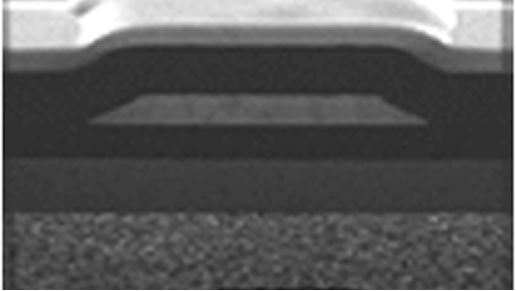
アルミ配線上への酸化膜コンフォーマル成膜
仕様
SPTのPECVDシステムは、膜厚・材料・デバイス要件の多様化に対応する柔軟な構成が可能です。研究開発から量産まで、酸化膜・窒化膜ともに安定した成膜性能を発揮します。

Cetus
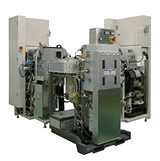
Capella
ウェーハサイズ (mm)
200
200
プラットフォーム
APX, DPX, VPX, CPX
APX, DPX, VPX, CPX
プロセス温度
Moderate
≤100°C
成膜可能材料
SiO2, SiN, SiON, SiC
SiO2, SiN

APX

DPX

VPX

CPX
用途
R&D
Prototype
Small Volume
Mass Production
チャンバー数
1
2
3
4
搬送ロボット
—
Atmospheric
Vacuum
Vacuum
ロボット・モーション
2-Axis
2-Axis
3-Axis
3-Axis
カセット数
0
2
1
2