Cetus, Capella
SPT的等离子体增强化学气相沉积(PECVD)系统可沉积高质量的硅氧化物与硅氮化物薄膜,具备低应力、优异的均匀性与可靠的覆盖能力。 适用于MEMS、光学镀膜与各种厚度的钝化膜沉积。
应用领域:
- MEMS器件
- 喷墨打印头
- 硅通孔(TSV)
- 功率器件
- LED器件
- 光学器件
- 射频器件(RF)

PECVD
SPT的PECVD系统专为先进MEMS与半导体应用中的厚氧化层与低应力硅氮化物沉积而设计。

功能特性
适用于MEMS与光波导应用的厚SiO₂膜沉积,确保无裂纹、无空隙。
在窄且高深宽比TSV结构上沉积低温氧化膜,实现高一致性。
适用于化合物半导体钝化,提供高密度、低氢含量的SiN膜。
形成高均匀性、超低应力的硅氮化物薄膜,可适用于MEMS膜应用。
可提供真空LoadLock与集群式平台,满足多种产能需求。
性能表现
SPT的PECVD系统可实现MEMS与TSV结构所需的厚氧化膜、低应力SiN与一致性薄膜。
以稳定可靠的工艺控制,实现真正重要的性能结果。
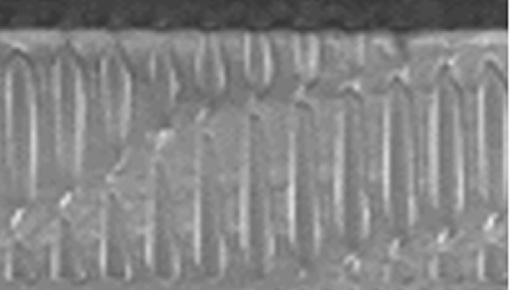
TSV结构无空洞氧化填充

厚SiO₂膜沉积

低应力SiN沉积
(剑桥大学提供数据)
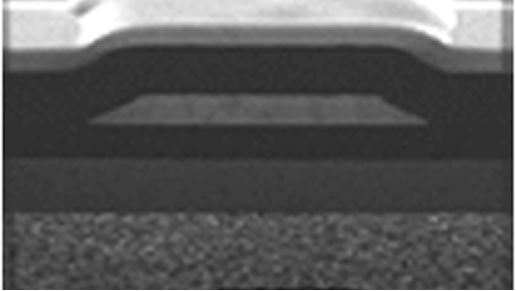
铝互连结构上等离子体SiO₂一致性覆盖
技术规格
SPT的PECVD系统提供多种配置选项,满足不同膜厚、材料与器件的应用要求。 适用于研发与量产,支持多种应用中稳定的氧化物与氮化物沉积。

Cetus
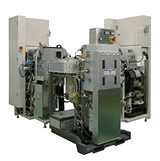
Capella
晶圆尺寸(mm)
200
200
搬送系统
APX, DPX, VPX, CPX
APX, DPX, VPX, CPX
工艺温度
Moderate
≤100°C
沉积材料
SiO2, SiN, SiON, SiC
SiO2, SiN

APX

DPX

VPX

CPX
预期用途
R&D
Prototype
Small Volume
Mass Production
腔体数量
1
2
3
4
搬送Robot
—
Atmospheric
Vacuum
Vacuum
Robot运输方式
2-Axis
2-Axis
3-Axis
3-Axis
Casseete数量
0
2
1
2