Predeus, Proxion
SPT提供两款Si DRIE系统——Predeus与Proxion——专为实现高深宽比深硅蚀刻而设计。两款平台均具备稳定、可重复的工艺性能,具备优异的均匀性与工艺控制,广泛适用于MEMS与先进封装应用。
应用领域:
- MEMS器件
- 喷墨打印头
- 硅通孔 (TSV)
- 功率半导体器件
- 光学器件

蚀刻技术
适用于深硅蚀刻的高精度Si DRIE系统,具备出色的各向异性与均匀性。专为MEMS、电力器件与先进半导体应用而设计。

功能特性
在保持垂直轮廓、侧壁光滑与最小CD损耗的前提下,SPT的Si DRIE系统实现业界领先水平的蚀刻速率与高选择性。
系统配备广泛的深硅蚀刻工艺库,支持快速配方开发与高重复性生产。
理想适用于功率MOSFET、200mm与300mm晶圆上的TSV形成,以及其他需要深度高深宽比结构的先进器件架构。
从真空LoadLock系统到全自动集群系统,SPT提供可扩展平台,支持研发与大批量Si DRIE制造。
性能表现
SPT的Si DRIE系统在多种结构中展现出卓越的深硅蚀刻性能。 无论是追求高深宽比、垂直侧壁、快速蚀刻速率,还是精准TSV形成,SPT平台均能提供所需的均匀性与工艺控制,满足先进半导体应用需求。

高深宽比蚀刻
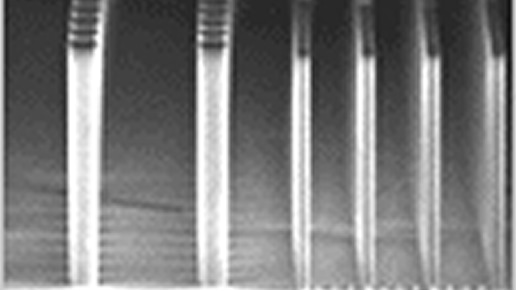
圆柱结构蚀刻

高速蚀刻
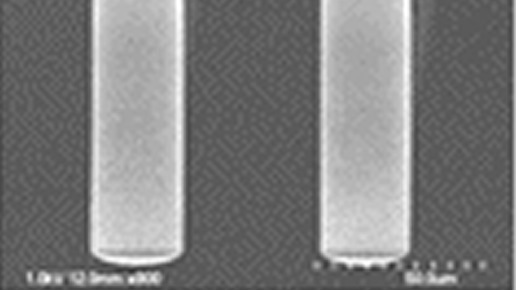
硅通孔 (TSV) 蚀刻
技术规格
SPT的Si DRIE系统通过模块化设计实现前所未有的灵活配置。 用户可根据具体生产需求选择合适的工艺模组与系统平台——无论是MEMS研发还是大批量TSV制造。

Predeus

Proxion
晶圆尺寸(mm)
200
200
搬送系统
APX, DPX, VPX, CPX
APX, DPX, VPX, CPX
蚀刻速率
Moderate
High
基板类型
Si
Si
应用领域
MEMS Gyroscope, MEMS Accelerometer
MEMS Microphone, Inkjet Printhead Manufacturing

APX

DPX

VPX

CPX
预期用途
R&D
Prototype
Small Volume
Mass Production
腔体数量
1
2
3
4
搬送Robot
—
Atmospheric
Vacuum
Vacuum
Robot运输方式
2-Axis
2-Axis
3-Axis
3-Axis
Casseete数量
0
2
1
2